使用Okamoto机械的研磨机和磨轮,配合Nitto半导体的研磨胶带和贴膜撕膜设备,可实现不同规格的晶圆减薄需求。




1. 工艺流程概述
晶圆背面减薄工艺主要包括以下几个步骤:
1. 晶圆清洗
2. 研磨胶带贴附
3. 晶圆背面减薄
4. 研磨胶带去除
5. 最终清洗与检测

2. 详细工艺流程
2.1 晶圆清洗
目的:去除晶圆表面的污染物和颗粒。
设备:超声波清洗机
清洗液:去离子水、异丙醇(IPA)
步骤:
1. 将晶圆放入超声波清洗机中。
2. 使用去离子水和IPA进行清洗,时间约为5-10分钟。
3. 用氮气吹干晶圆。
2.2 研磨胶带贴附
目的:保护晶圆正面电路在减薄过程中不受损伤。
材料:日东(Nitto)研磨胶带
设备:日东(Nitto)贴膜机
步骤:
1. 选择适合晶圆尺寸的日东研磨胶带。
2. 使用日东贴膜机将研磨胶带均匀贴附在晶圆正面。
3. 确保研磨胶带无气泡、无皱褶。

2.3 晶圆背面减薄
目的:将晶圆背面减薄至所需厚度。
设备:冈本(Okamoto)研磨机
磨轮:冈本(Okamoto)磨轮
参数:
研磨压力:根据晶圆材料和厚度调整
研磨速度:根据设备规格和工艺要求调整
冷却液:去离子水或专用冷却液
步骤:
1. 将贴有研磨胶带的晶圆固定在研磨机上。
2. 设置研磨参数,启动设备进行减薄。
3. 实时监控厚度,确保达到目标厚度。
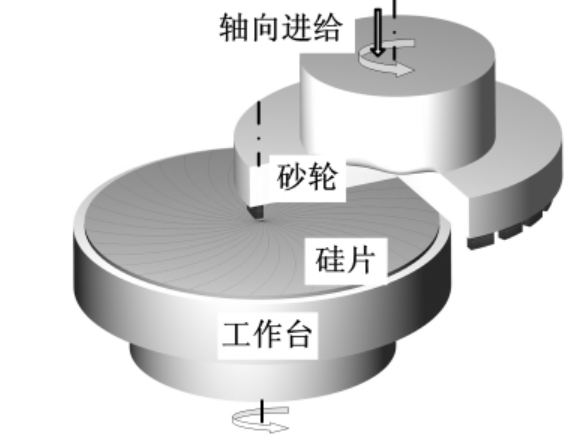

2.4 研磨胶带去除
目的:去除研磨胶带,恢复晶圆正面电路。
设备:日东(Nitto)撕膜机
材料:日东(Nitto)撕膜胶带
步骤:
1. 将减薄后的晶圆放入日东撕膜机。
2. 使用适当的溶剂或热风去除研磨胶带。
3. 确保研磨胶带完全去除,无残留。
2.5 最终清洗与检测
目的:去除减薄过程中产生的颗粒和污染物,进行最终检测。
设备:超声波清洗机、检测设备
清洗液:去离子水、IPA
步骤:
1. 将晶圆放入超声波清洗机中进行最终清洗。
2. 用氮气吹干晶圆。
3. 使用检测设备进行厚度、表面粗糙度、缺陷等检测。
3. 设备与材料选择
- 研磨胶带:日东(Nitto)研磨胶带,型号根据晶圆尺寸和工艺要求选择。
- 贴膜机:日东贴膜机,型号根据晶圆尺寸和工艺要求选择。
- 撕膜机:日东撕膜机,型号根据晶圆尺寸和工艺要求选择。
- 研磨机:冈本(Okamoto)研磨机,型号根据晶圆尺寸和减薄要求选择。
- 磨轮:冈本磨轮,型号根据晶圆材料和厚度要求选择。
4. 工艺参数优化
研磨压力与速度:根据晶圆材料和厚度进行优化,确保减薄均匀且无损伤。
冷却液:选择适合晶圆材料的冷却液,确保工艺稳定。
5. 质量控制
厚度控制:使用厚度测量仪实时监控减薄过程中的厚度变化。
表面粗糙度控制:使用表面粗糙度仪检测减薄后的表面质量。
缺陷检测:使用缺陷检测设备检测晶圆表面的缺陷和污染物。
通过以上工艺流程和方案,结合日东研磨胶带、贴膜机、撕膜机和冈本研磨机、磨轮的优势,可以实现高效、高质量的晶圆背面减薄。工艺参数的优化和质量控制是确保最终产品符合要求的关键


地址:上海市青浦区华隆路1777号E栋905A




邮箱:jay@kindaku.com

